封裝是連接芯片和外部電路的橋梁,封裝技術對芯片性能的影響主要體現在幾個方面:
提升系統性能:隨著摩爾定律迭代速度放緩,先進封裝技術成為提升系統性能的另一發展主軸。通過集成化封裝,可以在不縮小制程節點的背景下,僅通過改進封裝方式就能提升芯片性能。
提高信號傳輸效率和穩定性:封裝技術能夠保護芯片免受環境因素的影響,同時提高信號傳輸效率和穩定性,這對于芯片性能的穩定發揮至關重要。
增強芯片性能:封裝技術通過提高集成度來滿足現代電子設備功能日益復雜的需求。一方面,增加單個芯片的功能密度;另一方面,通過系統級封裝(SiP)等技術將多個不同功能的芯片集成在一起,形成一個完整的系統,從而增強芯片性能。
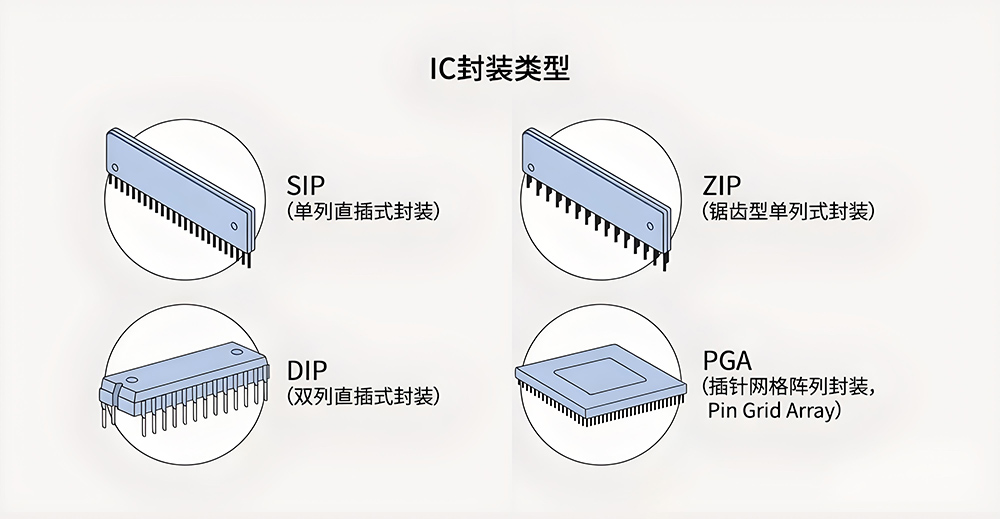
降低信號傳輸延遲:高性能封裝工藝發展包括提高芯片的電氣性能,例如降低信號傳輸延遲、提高信號完整性等。通過采用先進的封裝技術,如倒裝芯片(Flip - Chip)技術和球柵陣列封裝(BGA)技術,可以實現更短的電氣連接路徑,從而減少信號傳輸過程中的延遲和損耗。
改善散熱性能:隨著芯片的集成度和性能的提高,芯片產生的熱量也越來越多。新型的封裝技術注重改善散熱性能,例如采用散熱性能更好的封裝材料、優化封裝結構以增加散熱路徑等,這對于維持芯片性能和可靠性至關重要。
三維封裝(3D封裝):三維封裝技術通過堆疊不同的芯片層,可以在有限的空間內實現更高的集成度和性能,這對于提升芯片性能和實現更復雜的功能具有重要意義。
保護芯片免受損害:封裝材料可以保護芯片免受微粒、濕氣和機械力等外界因素對它的損害,同時也增強了散熱。
隨著技術的發展,多樣性的應用需求創造了一系列的封裝媒介和封裝工藝。

以下是一些常見的功率芯片封裝類型:
TO封裝:包括TO-220和TO-247等,這些是分立式封裝,廣泛應用于小功率范圍,需要焊接到印刷電路板上。由于功率損耗相對較低,散熱要求不高,這種封裝設計通常不采用內部絕緣,每個封裝中只有一個開關。
模塊層疊結構:包括TO-247單管封裝及模塊封裝,外殼、芯片、端子和鍵合線是其主要組成部分。
翻轉貼片封裝:阿肯色大學團隊借鑒BGA的封裝技術,提出了一種單管的翻轉貼片封裝技術,可以有效減小雜散電感值,將其大小控制在5nH以下。
DBC+PCB混合封裝:這種封裝方式結合了兩種成熟工藝的優勢,易于制作,可實現低雜散電感以及更小的體積。
SKiN封裝:由Semikron公司利用SKiN封裝技術制作的1200V/400A的SiC模塊,采用柔性PCB板取代鍵合線實現芯片的上下表面電氣連接,模塊內部回路寄生電感僅有1.5nH。
DLB、Cu-Clip、SiPLIT封裝:這些封裝技術通過平面互連的方式實現芯片正面的連接,減小電流回路,進而減小雜散電感、電阻,還擁有更出色的溫度循環特性以及可靠性。
在不同領域,不同產品又各有特點,舉例幾個在功率芯片中最常用的封裝規格:
TO-220/220F:這是一種分立式封裝,廣泛應用于小功率范圍。TO-220F是全塑封裝,裝到散熱器上時不必加絕緣墊;而TO-220帶金屬片與中間腳相連,裝散熱器時要加絕緣墊。
TO-251:這種封裝產品主要是為了降低成本和縮小產品體積,主要應用于中壓大電流60A以下、高壓7A以下的環境中。
TO-92:這種封裝只有低壓MOS管(電流10A以下、耐壓值60V以下)和高壓1N60/65在使用,目的是降低成本。
TO-252(D-PAK):這是一種塑封貼片封裝,常用于功率晶體管、穩壓芯片的封裝,是目前主流封裝之一。采用該封裝方式的MOSFET有3個電極,柵極(G)、漏極(D)、源極(S)。其中漏極(D)的引腳被剪斷不用,而是使用背面的散熱板作漏極(D),直接焊接在PCB上,一方面用于輸出大電流,一方面通過PCB散熱。
TO-263(D2PAK):這是TO-220的一個變種,主要是為了提高生產效率和散熱而設計,支持極高的電流和電壓,在150A以下、30V以上的中壓大電流MOS管中較為多見。